
EM-Tec M-1 und M-10 Rasterkalibrierstandards
EM-Tec LAMC-15 großflächiger Vergrößerungsstandard
EM-Tec REM Probentelleradapter
EM-Tec M-1 und M-10 Rasterkalibrierstandards
mit 1 µm und 10 µm Teilung, NIST rückverfolgbar
Einleitung
Die EM-Tec M1 und M-10 Kalibrierstandards haben beide in ein ultraflaches Si-Substrat eingeätzte, quadratische Rastermaschen. Die Rastermaschen sind hilfreiche, praktische Werkzeuge bei der Kalibrierung der Vergrößerung und zur Beurteilung der Bildverzerrung. Sie sind gedacht für den Einsatz in REM, FE-REM, FIB, Auger, SIMS und Auflichtmikroskopen. Proben können auch direkt auf den Standards befestigt werden. Dann dient das Rastermuster des Standards im Hintergrund zur direkten Kalibrierung des Bildes. Dies ist besonders nützlich bei kleinen Proben und Pulvern. Die EM-Tec M1 und M-10 Kalibrierstandards werden mit einem NIST rückverfolgbaren Wafer-Level-Zertifikat geliefert.
Es gibt zwei verschiedene Rasterkalibrierstandards:
- EM-Tec M-1 mit einer 1 µm Teilung für 100x bis 10.000x Vergrößerung
- EM-Tec M-10 mit einer 10 µm Teilung für 100x bis 1000x Vergrößerung
EM-Tec M-1 mit einer 1 µm Teilung für 100x bis 10.000x Vergrößerung
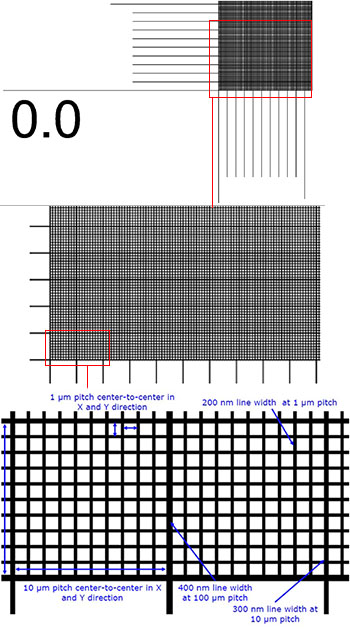
Details EM-Tec M-1 mit 1 µm Grid-Raster Teilung
für 100x bis 10.000x Vergrößerung.
Bestellinformationen
Der EM-Tec M-1 mit einer 1 µm Teilung mit stärkeren Linien alle 10 und 100 µm. Er ist hilfreich bei der Kalibrierung im Vergrößerungsbereich von 100x bis 10.000x und zur Beurteilung der Bildverzerrung. Kleine Proben können für sofortige Kalibrierung oder Kalibriermaßstab im Bild direkt auf das Rastermuster aufgebracht werden. Die Linien sind direkt in ein ultraflaches Siliciumsubstrat geätzt, das gegenüber SiO2 geätzten Substratn ein hervorragendes Signal erzeugt.
| Substrat | 525 µm dicker, ultraflacher Wafer mit <100> Orientierung |
Leitfähigkeit |
Sehr gut, 5-10 Ohm Widerstand |
Rastergröße |
3 x 3 mm |
Teilung/Präzision |
1µm ± 0,025µm, 10µm ± 0,025µm und 100µm ± 0,25µm |
Linienart/-tiefe |
Geätzt in Si, 300 nm ± 30 nm tiefe Linien |
Linienbreite |
200 nm ± 10 nm bei 1 µm Teillinien |
Rechtwinkligkeit |
Besser 0.01° |
Markierungen |
Ecken-Bezugsmarkierungen zur Findung der Gridposition |
Würfelgröße |
4 x 4 mm |
| Anwendungsbereich | REM, FE-REM, FIB, Auger, SIMS und Auflichtmikroskope |
Kennzeichnung |
Produkt-ID mit eingeätzter Seriennummer |
Befestigung |
Nicht montiert oder auf verschiedenen Trägern |
Lieferung |
Geliefert in Gel-Pak Box |
Zertifizierung |
Wafer-Level-Zertifikat auf Rückverfolgbarkeit, NIST |
EM-Tec M-10 mit einer 10 µm Teilung für 100x bis 1000x Vergrößerung

Details EM-Tec M-10 with 10µm pitch grid pattern
for 100x to 1000x magnification Sortiment
Bestellinformationen
Der EM-Tec M-10 mit einer 10 µm Teilung mit stärkeren Linien alle 100 µm. Er ist hilfreich bei der Kalibrierung im Vergrößerungsbereich von 100x bis 1000x und zur Beurteilung der Bildverzerrung. Kleine Proben können für sofortige Kalibrierung oder Kalibriermaßstab im Bild direkt auf das Rastermuster aufgebracht werden. Die Linien sind direkt in ein ultraflaches Siliciumsubstrat geätzt, das gegenüber SiO2 geätzten Substratn ein hervorragendes Signal erzeugt.
| Substrat | 525 µm dicker, ultraflacher Wafer mit <100> Orientierung |
| Leitfähigkeit | Sehr gut, 5-10 Ohm Widerstand |
Rastergröße |
3 x 3 mm |
| Abstand/precision | 10µm ± 0,025µm und 100µm ± 0,25µm |
Teilung/Präzision |
Geätzt in Si, 300 nm ± 30 nm tiefe Linien |
Linienbreite |
300nm ± 15nm bei 10 µm Teillinien |
Rechtwinkligkeit |
Bettes 0.01° |
Markierungen |
Ecken-Bezugsmarkierungen zur Findung der Gridposition |
Würfelgröße |
4 x 4 mm |
| Anwendungsbereich | REM, FE-REM, FIB, Auger, SIMS und Auflichtmikroskope |
Kennzeichnung |
Produkt-ID mit eingeätzter Seriennummer |
Befestigung |
Nicht montiert oder auf verschiedenen Trägern |
Lieferung |
Geliefert in Gel-Pak Box |
Zertifizierung |
Wafer-Level-Zertifikat auf Rückverfolgbarkeit, NIST |
Bestellinformationen
|
||||||||||||||||||||||||||||||||||||||||
|
||||||||||||||||||||||||||||||||||||||||







